摘要:
随着集成电路(IC)的复杂度不断提高,使用额外的成熟且有效的失效分析技能的能力变得重要起来。活性电子束探测是行之有效的微电子失效分析方法,可通过适当配置的扫描电子显微镜(SEM)来应用。在现有失效分析实验室中,我们检查了电阻对比成像(RCI)和电子束感应电流(EBIC),并成功将其用作失效点隔离技术。从这些技术获得的结果得到了其它失效分析方法的支持,例如光学显微镜和曲线轨迹分析等。最后,本文证明电子束探测技术有助于增强现有失效分析过程的深度。
I. 引言和背景
扫描电子显微镜
扫描电子显微镜(SEM)是微电子学中的标准工具,在失效分析中有广泛的应用。SEM从阴极产生电子,并通过电子枪予以加速。电子枪的阴极和阳极之间的电位差决定电子的加速度。所产生的电子能量用电子伏特(eV)来衡量1。SEM的常规应用主要是表面形貌成像。二次电子(SE)提供高分辨率、大深度的场图像2。SE配置是扫描电子显微镜的最常用模式。还有其它配置,例如背散射电子(BSE)成像和能量色素X射线(EDX)分别使用背散射电子和X射线发射,以便在样品的表面及下方进行不同水平的元素分析2,3。单单SE、BSE和EDX这些技术就足以使SEM成为失效分析实验室的基础工具。
活性电子束探测分析
除了上述SEM模式以外,还可以在其它独特配置下使用SEM,以提供额外的失效分析能力。利用活性电子束探测可以隔离失效,而无需对集成电路有细致的了解。这套技术利用的是SEM电子束能量与集成电路交互的能力,从该交互获得的信息可以进行分析4。电子束感应电流(EBIC)和电阻对比成像(RCI)是两种活性电子束探测方法,分别可以在集成电路的扩散层和导电层找出失效位置。RCI与EBIC的主要区别是加速电压(电子束能量)不同。由于可以通过电子束能量(1-30 KeV)将穿透深度调整到期望的分析水平,因此可以实现RCI或EBIC效应4。简单地说,穿透到浅导电层(RCI)所需的电子束能量远低于穿透到更深的扩散层(EBIC)所需的电子束能量。
电子束感应电流(EBIC)
执行EBIC成像所需的设备是扫描电子显微镜、电流放大器和电真空馈通。唯一需要的样品制备步骤是对器件封装进行开封3。EBIC相对于其它活性束探测技术的一个优势是分析时不需要消除钝化层。此外也不需要电源,因为待测器件使用电子束能量来产生提供信号所需的电流3。在EBIC分析期间,从电子束注入的电子打破半导体均衡状态,产生电子/空穴对。在空乏区,自然电磁场消除过多的电荷,产生更大反相偏置电流。因此,EBIC信号主要是从嵌入的扩散层(晶体管和二极管)产生5。执行测量不会损坏集成电路的表面。通过放大电子束产生的电流或电压,便可由该效应形成SEM监视图像。
EBIC局限性
EBIC是一种非常有价值的双极性半导体器件评估技术。然而,EBIC分析局限于MOS技术的评估。栅极氧化物对一次电子注入的灵敏度是限制性设计因素。电子/空穴对的产生导致绝缘体充电,引起陷阱电荷。该效应可产生寄生MOS晶体管或静电放电损害(ESD)。根据作用于氧化物的电子束能量剂量不同,损害可能是IC漏电流增加到晶体管完全失效。
EBIC的另一个局限性与IC复杂度的提高有关。随着结深度增加和结构的复杂度提高,EBIC变得愈加困难2。此时,与EBIC相对应的一种称为"光束感应电流"(OBIC)的技术可能更有效。OBIC使用扫描光学显微镜(SOM),由于其IR特性,可以通过背部分析集成电路4。随着集成电路的不断发展和复杂度的提高,OBIC等技术的价值将得到更好的体现。
电阻对比成像(RCI)
与EBIC相似,RCI利用SEM在钝化器件的两个节点之间产生一个电阻图像。与EBIC成像不同的是,它使用较低的电子束能量,一次电子仅达到导电层,而未达到晶体管层。然而,RCI的电子束能量必须足够大,以便将电子注入器件的导电层。.
为了获得RCI信息,提高一次电子束能量,直至电子束能量的尖端达到目标导电层。由于所有集成电路的通用性,RCI一般将电源和接地输入用作测试节点。通常,接地引脚接地,Vcc引脚连接到电流放大器。该技术将信号(na)传送到电流放大器,输出显示在SEM监视器上。由此获得的图像可以显示金属层中的开路和短路。相对于所选的测试引脚组合(开路导线),如果一条导线的电阻发生变化,RCI图像将在开路处显示一个突兀的对比变化3-5。RCI主要用于检查金属、多晶硅、金属到硅测试结构和薄膜电阻导线分布图3。
只有相对于连接到RCI电流放大器输入端的节点的电阻变化才会被显示。必须选择适当的节点,并且不能测试未直接通往输出引脚的导线。因此,RCI在集成电路上的使用可能有限,并且难以解释3,4。然而,ATE或曲线轨迹分析等电气测试可为RCI确定最有利的节点连接,最大程度地消除此劣势。.
II. 系统设置
本测试使用的扫描电子显微镜是日立S-2700型,它配备日立S6548电流放大器,具有增益和抑噪控制功能。样品室配有一个24引脚电真空馈通。该SEM安装于2001年6月,第一批活性电子束探测分析试验于2001年9月进行。
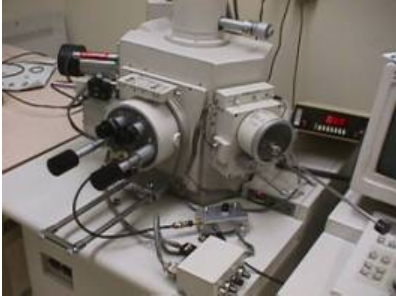

外部接地的样品封装引脚利用导电银膏连接到试样级。涂上银膏后,烘烤该级和试样以固化到该级的接地连接。待分析器件的所有其它引脚均被向上弯曲(对于DIP封装)并保持悬空。我们认识到,也可以使用配备适当配置的测试插座的一级来代替上述更具破坏性的直接连接方法。
然后将一条引线焊接到Vcc等目标引脚,最终连接到电气馈通。电气馈通最终连接到电流放大器,所产生的信号显示在SEM监视器的辅助1输出上。
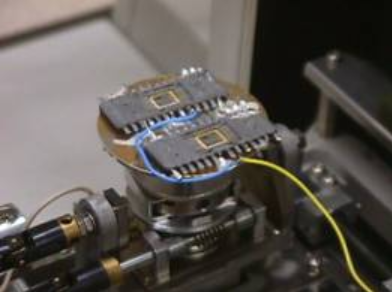
将样品放入SEM时,为了能将样品的焊接引线连接到电气馈通,必须将整个试样室稳定在室温。
检查到真空馈通的导线连接的连通性,然后对试样室抽真空以开始分析。实现高真空所需的等待时间约为8分钟。
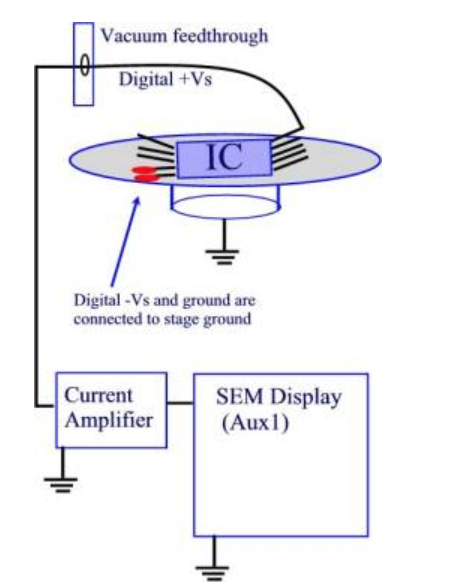
运行EBIC和RCI需要采用慢速扫描显示模式。在TV(快速扫描)模式下,图像会模糊不清(20 ms)7,这是因为RCI或EBIC信号的响应输出较慢。导航问题的解决办法是将一台监视器设置为SE模式,将另一台监视器设置为电流放大器输出(辅助1)。结合SE模式,快速切换到快速扫描模式即可提供导航目标区域所需的实时图像。
III. RCI结果
为了检验RCI的能力,使用了一个12位数模转换器(DAC),它采用双极性NPN晶体管技术,具有40 MHz乘法带宽。将该单元开封,找到数字+Vs输入、数字-Vs输入和数字地。
在位1 (MSB)输入正前方的数字+Vs金属走线上切一个开口。该开口利用一台配备激光的Karl Suss探测台产生,此设备用于消除钝化层或切割金属走线。利用光学显微镜、SEM (SE)和曲线轨迹分析检查切口的结果。

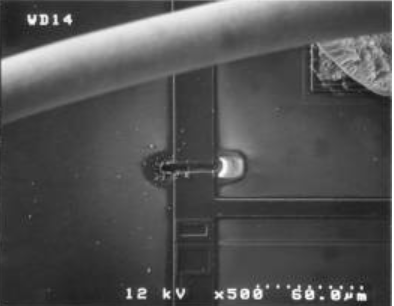
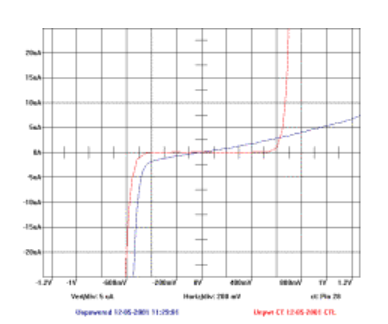
在针对RCI的样品制备中,数字地引脚和数字-Vs利用银膏连接到该级。在125C烤箱中将该单元和该级烘烤10分钟。一条引线焊接到+Vs输入引脚。该级在SEM中放置就绪后,数字+Vs引脚连接到电真空馈通。对于RCI,SEM加速电压降至12kV。
由此产生的设置和分析清楚地显示了一条暗轨迹,从Vs焊垫开始,终止于位1前的切口。显然,RCI快速清晰地识别出金属走线的电阻变化(开路)。在SEM中设置完毕后,识别开路所需的时间约为3分钟。


IV. EBIC结果
使用第二个12位40MHZ双极性DAC来检验EBIC的能力。这种情况下,向位1的输入提供3个连续的4000 V ESD脉冲。对位1 (MSB)输入的曲线轨迹分析确认了由此造成的电气损害。
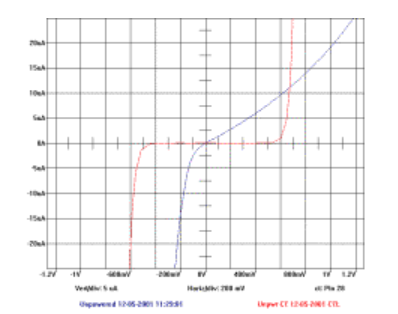
样品开封后,光学显微镜分析和SEM分析无法确认任何可视损害。
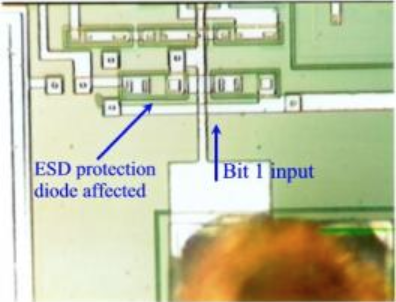

在EBIC制备中,数字地引脚和两个数字-Vs引脚利用银膏连接到该级。在125C烤箱中将该单元和该级烘烤10分钟。然后,将一条引线焊接到+Vs输入引脚。该级在SEM中放置就绪后,+Vs引脚连接到电真空馈通。
对于EBIC系统配置,SEM加速电压提高到30 kV,以便电子束能够穿透试样的扩散层。
检查位1晶体管区域,发现目标区域中有一个结构不吸收电流。
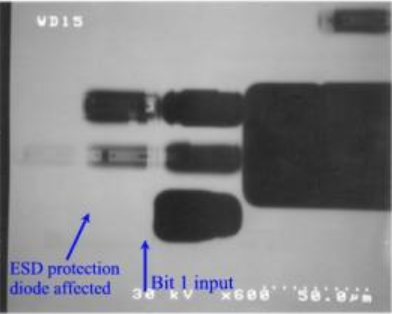
所有其它(其余11个)输入位均显示有一个结构在吸收电子束电流。检查裸片图和此器件的原理图后,发现缺少的结构为连接到位1 (MSB)输入的ESD抑制二极管。因此,EBIC分析可严格确定失效结构。在SEM中开始检查后,识别受损结构的总时间为10到12分钟。

整合到当前失效分析过程和未来的工作中
上一部分呈现的结果是本失效分析实验室成功产生的首批RCI和EBIC图像。在现有失效分析过程中增加一个新的维度是一个令人振奋的机会。RCI和EBIC将作为一项通用故障隔离技术,被集成到现有失效分析过程中。这些技术的主要作用是进一步明确曲线轨迹分析的发现。在失效分析过程中增加RCI和EBIC,可将电气异常缩小到特定结构,从而提高分析能力。此外,在某些情况下,如果ATE数据或失效分析记录能够提供足够信息来缩小失效范围,确保引脚连接正确,可能就不需要曲线轨迹分析数据。

整合RCI和EBIC的下一步是检查其对ESD测试失效的有效性。第一芯片阶段中的集成电路在发布之前会经历广泛的ESD测试。在ESD测试不符合设计标准的情况下,可能需要对IC进行EBIC或RCI检查以找出根本原因。在发布过程中,成功且快速的根源分析可节省宝贵的时间。
本实验室执行的大部分失效分析采用多芯片模块(MCM)技术。获得有效的RCI和EBIC结果后,未来工作将聚焦于MCM的应用。已确定的潜在应用是焊线失效分析、MCM基底开路分析和即将开始的集成电路分析。此外,未来还将考察EBIC在MOS集成电路技术上的局限性。
电压对比(VC)
下一步发展将聚焦于另一种活性电子束探测技术,称为"电压对比"(VC)。在电压对比成像产生的图像中,对比度主要由器件的静态电压决定。通过亮度分析可以确定数字器件的逻辑电平。这样就可以确定内部电路节点的电压。然而,在钝化表面上,不良电子束穿透可能会引起充电。由于这一效应,通常建议执行去钝化3,5。鉴于这一点,未来适合VC评估的候选器件将考虑简化开封和去钝化步骤。
电压对比的另一个目标应用是检查截面电容。电压对比可以产生对比图案以帮助区分好电容与坏电容6。
电荷感应电压调变(CIVA)
未来我们关注的还有一项称为"电荷感应电压调变"(CIVA)的技术。在器件偏置的同时,测量恒流源的电压变化来产生图像。
随着电子被提供给良好导线,额外电流(na)被吸收,结果是电源电压实际上无变化。在失效导线中,导线的电压变化变得可以测量。因此,CIVA是适合导线开路分析的出色技术。相比于RCI或EBIC,CIVA需要的唯一附加设备是恒流源。与RCI和EBIC一样,器件不需要去钝化2,4。CIVA与EBIC和RCI的相似性,使得CIVA自然成为我们要研究的下一种活性电子束探测方法。
VI. 结论
活性电子束探测是行之有效的微电子失效分析方法,可通过使用适当配置的扫描电子显微镜(SEM)来应用。应用电阻对比成像(RCI)技术,成功发现了IC中的断开导线。电子束感应电流(EBIC)也被成功应用于寻找集成电路上的受损ESD保护二极管。在现有过程中增加RCI和EBIC,可将此失效分析工具组合提升到新的高度。未来将继续探索RCI和EBIC的新应用。此外还将研究其它活性电子束探测技术,如电压对比(VC)和电荷感应电压调变(CIVA)等。
致谢
感谢多芯片产品质保经理Elaine Trotter分配所需的时间和资源来完成这些实验。
感谢新墨西哥大学Chuck Hawkins教授通过其(NTU)微电子失效分析研究生课程使我们注意到这项技术。
参考文献
J.R. Beall, "Electron Beam Induced Current Application Techniques", 1997 ASM International
E.I. Cole and J.M. Soden, "Scanning Electron Microscope Techniques for IC Failure Analysis" 1997 ASM International
W. Lee and S.V. Pabbisety, Microelectronic Failure Analysis, Desk Reference, 3rd Edition, 1993 ASM International
L.C. Wagner, Failure Analysis of Integrated Circuits, 1999 Kluwer Academic Publishers
D.L. Burgess and O.D. Trapp, Failure and Yield Analysis Handbook, 1992 Technology Associates
D.T. Wei, "Identification of Ceramic Capacitor Shorts by Voltage Contrast in Scanning Electron Microscope." 1997 ASM International
Instruction manual for Model S-2700 scanning electron microscope, 1989
January 2002
Generic_Author_image
关于作者M. B. Ferrara and G.G. Owen
Analog Devices, Inc.
7910 Triad Center Drive Greensboro, North Carolina 27409





